Neuester Blog
Leiterplatten-Laser-Depanelisierung mit einer Hochleistungs-UV-Laserquelle 355nm
Feb 06 , 2023Leiterplatten-Lasertrennen mit einer Hochleistungs-UV-Laserquelle
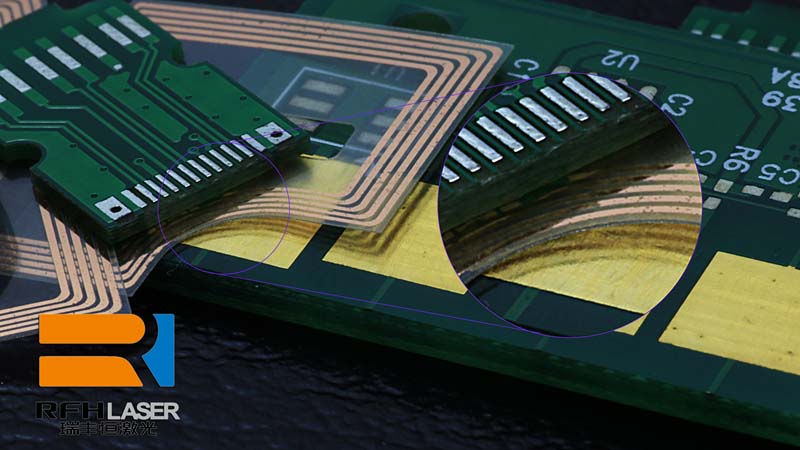
Eine der immer beliebter werdenden Methoden zum Vereinzeln von starren/flexiblen, starren und flexiblen Schaltungen
Die nachträgliche Montage der Platinen erfolgt durch die Verwendung von Laser-Routing. Diese Methode hat die
Vorteil von Geschwindigkeit, Positionsgenauigkeit, kein Werkzeugverschleiß und schließlich kein induzierter
mechanische Beanspruchung von Bauteilen während des Vereinzelungsprozesses.
Es gibt mehrere Fälle, in denen das Laserfräsen von Leiterplatten wünschenswert ist:
o wenn ein hohes Maß an Präzision bei der Endmontage erforderlich ist (think
„fester Sitz“ einer Platine in einer Baugruppe) oder
o wenn zahlreiche Materialien durchgeschnitten werden müssen und die Anzahl und
Art der Depaneling-Schritte ist zu begrenzen (denken Sie an „keine Kompromisse
Schneiden eines Materials mit einer Technik, die bei a nicht gut funktioniert
zweites oder drittes Material“) oder wann
o ungewöhnliche Brettformen in einem Design auftauchen oder wann schließlich
o Hochempfindliche Bauteile werden in der Nähe der Ausschnitte der Leiterplatte platziert
vorsichtig behandelt werden müssen.
Für Leiterplatten stehen verschiedene Trennmöglichkeiten zur Verfügung, jede mit ihren eigenen
eigene Reihe von Vor- und Nachteilen.
Leiterplattentrennoptionen
Die Methoden zum geradlinigen Vereinzeln von Leiterplatten, die für rechteckige Formen eingerichtet sind
Leiterplatten, alle schneiden oder quetschen die Kante der Platine. Zu diesen Methoden gehören Stanzen,
Stanzen oder V-Rillen der Baugruppe oder Verwendung eines Radschneiders oder einer Säge.
Das Sägeverfahren verwendet typischerweise ein einzelnes rotierendes Blatt, das sich mit hoher Drehzahl dreht, um zu schneiden
das Paneel in die gewünschten Formen. Dieses Verfahren erzeugt Wärme im ausgeschnittenen Bereich als
sowie die Erzeugung von Trümmern als Nebenprodukt des Schneidvorgangs.
Beim V-Ritzen beträgt die Dicke der Platte 30–40 % der ursprünglichen Platte
Dicke, da es von beiden Seiten der Platte geschnitten wird. Nach dem Zusammenbau ist die Platine kaputt
an dieser v-Score-Linie. Abwechselnd schneidet ein „Pizzaschneider“ durch die V-Nut der Platte
und schneidet die verbleibende Bahn, bis die Bretter dadurch ihre endgültige ausgeschnittene Form haben
Belasten Sie die Komponenten und Lötstellen - insbesondere in der Nähe der Platine
Rand.
Bei einem anderen Verfahren kann der vereinzelte Platinenumriss aus der Tafel ausgestanzt werden.
Dies erfordert, dass für jeden einzelnen Leiterplattentyp ein neuer Stempel verwendet wird
bedeutet, dass es sich nicht um eine flexible Methode zum Ausschneiden von Platinen handelt. Die Stanzkraft kann auch biegen oder
die Kanten der Leiterplatte verformen. Scharfe Kanten eines gut gepflegten Würfels müssen die Norm sein
um einen fehlerfreien Ausschnitt zu erhalten.
Beim Platinenfräsen und anschließendem „Knabbern“ an einem Platinenumriss kann es auch sein
ausgeschnitten. Die Platinen werden vor der Montage geroutet. Die restlichen befestigt
Punkte werden mit einem kleinen Bohrer gebohrt, wodurch es leichter zu brechen ist
die Bretter aus der Tafelpfosten-Brettbaugruppe heraus. Dies hinterlässt sogenannte „Mausbiss“-Muster. Das Routing nimmt Platz auf dem Panel ein
da es rund um die Kante des Plattenschnitts Sperranforderungen gibt
aus Bereich. Die Führung kann auch die Paneelsteifigkeit verringern, was typischerweise der Fall ist
in der Anfangsphase der Leiterplattenbestückung erforderlich und gewünscht
Verfahren. Der Vorteil des Fräsverfahrens besteht darin, dass mit dem Fräser gekrümmte und nichtlineare Linienmuster geschnitten werden können.
Bei jeder der oben genannten Techniken, die alle mechanischer Natur sind, wird das Brett
Kanten, Teile in der Nähe des Ausschnitts sowie die Lötstellen haben einen hohen Grad an
Belastungen, die während des Schneidvorgangs auf sie ausgeübt werden. Diese Spannung kann eine Delaminierung von verursachen
die Platte in der Nähe ihrer Kanten oder entwickeln Sie Raum in und um die Glasfasern in der Nähe der Platte
Rand. Diese beiden Anomalien können zum Eindringen von Feuchtigkeit in die Platine führen
später zu Zuverlässigkeitsproblemen führen. Diese potenziellen Probleme vergrößern die „Keep
out“-Bereiche der Komponenten entlang der Peripherie der Platinen.
Laserbearbeitungsoptionen
Es gibt mehrere Verfahren, mit denen die Laserbearbeitung verwendet werden kann, um die Platine herzustellen
Schnittmuster einschließlich Perforationen, Haltelaschen und Rillen. Die Präzision der
Die Laserschneidquelle ermöglicht das Vereinzeln viel kleinerer Leiterplattengeometrien. Der
Die Präzision des Lasers ist ziemlich eng, insbesondere im Vergleich zu anderen mechanischen
Methoden. Die C02-Laserquellen sind positionell und dimensional innerhalb von 2 mils (50 um)
während die UV-Quellen innerhalb von 1 mil (25 um) liegen

Perforationen
Ähnlich wie Ritzen oder V-Nuten sind Laserperforationen eine weitere Option für werkzeuglose Leiterplatten
Entfernung von einer Platte. Perforationen können in jeder Größe und jedem Abstand lasergeformt werden, um sie zu erfüllen
die gewünschten Löse- und Sicherungskräfte.
Haltelaschen
Haltelaschen sind kleine ungeschnittene Abschnitte um das Brett, die verwendet werden, um das Brett in der zu sichern
Tafel. Die Haltelaschen werden aufgrund der einfachen Handhabung von Kleinteilen oder Teilen verwendet
Sicherung für die Weiterverarbeitung. Die Haltelaschenbreite wird basierend auf gewählt
gewünschte Kraft, um die einzelne Platte von der Platte/Folie zu entfernen, oder bekannt
Kräfte, die durch nachgelagerte Prozesse wie Bauteilbeladung oder Elektropolieren aufgebracht werden. Der Laser kann Laschen in fast jedem Material und in jeder Breite und Position erstellen
über das Brett.
Punkte
Das Laserritzen erzeugt eine Ablationslinie mit begrenzter Tiefe in dem Plattenmaterial oder den Materialien.
Die Tiefe beträgt im Allgemeinen 50 % der Materialdicke, kann aber auf einen gewünschten Wert gesteuert werden
Tiefe. Die Kerbung wirkt ähnlich wie die Haltelasche, um die Leiterplatte in der Platte zu sichern, aber
ermöglicht das „Ausklinken“ einzelner Teile. Laserritzlinien können auch als verwendet werden
absichtlicher Weg für Spannungsabbau oder Rissausbreitung.
Funktionsweise von 355-nm-UV-Lasern
UV-Laser, die bei 355 nm arbeiten, werden zum Abtragen oder Auflösen des Plattenmaterials verwendet. A
Ein hochenergetischer Laserpuls verdampft und entfernt die oberste Schicht explosionsartig und verwandelt sie in
Mikrostaubpartikel. Dies erfordert, dass das Material, sei es FR-4, Polyimid,
Metalle oder eine Kombination davon müssen in der Lage sein, den Impuls zu absorbieren. Der Laser
Strahl geht hin und her über die durchgeschnittene Stelle, die jeweils ein wenig abgetragen wird.
Dies bedeutet, dass nur eine geringe Materialmenge auf einmal verdampft wird
Der lokale Erwärmungseffekt wird minimiert. Tatsächlich wurden Messungen in der Nähe des Schnittbereichs durchgeführt
(innerhalb von 1,5 mm des Schnittbereichs) zeigen, dass der Temperaturanstieg weit unter 1000°C unter dem des Reflow-Profils liegt (1). Während andere Laser mit kürzerer Wellenlänge mehr sein können
leistungsoptimiert, ihr Einsatz ist jedoch durch ihren hohen Kapitalbedarf limitiert
Um die Schnittzeit und den damit verbundenen Aufwand zu reduzieren, wird der Laserstrahl „beam
gesteuert“ mit einem Galvanometer (Galvo). Diese zeichnet den Schnittpfad im Material hinüber
ein kleiner Bereich. Dieser Scanner-Ansatz richtet den zu bewegenden Strahl mit einer sehr hohen Geschwindigkeit aus
der Geschwindigkeit am selben Ort über einen kleinen Bereich. Diese Drehzahl liegt im Bereich von 100 bis
1000 mm/Sek. Dadurch wird sichergestellt, dass sich der Strahl nur kurzzeitig im selben Bereich befindet
Zeit, wodurch lokale Erwärmungseffekte minimiert werden.
Die Bezugspunkte der Platine können helfen, die relative erforderliche Position des Strahls zu bestimmen
Schneidestelle. Ein XY-Präzisionstisch wird für größere mechanische Bewegungen und verwendet
Anpassungen, während der Galvo die Mikrobewegungen und Anpassungen übernimmt
Standort.
Abschluss
Das Laser-Nutzen von Leiterplatten hat seine Anwendungsnische dort, wo Leiterplatten enge Abstände haben,
wo geometrische Toleranzen kritisch sind und wo die Ausschnittpositionslinien sehr sind
in der Nähe von Komponenten. Das Verfahren ermöglicht ein präzises Ausschneiden der Bretter während des
Vereinzelungsprozess mit sehr geringer Erwärmung der Platine und sehr geringer mechanischer Belastung
im Vergleich zu herkömmlichen Leiterplattentrenntechniken.